Aplicaciones:
Nanoestructuras
Análisis in situ de aplicaciones especiales como modificación de superficies, análisis de fallas y análisis químico de superficies
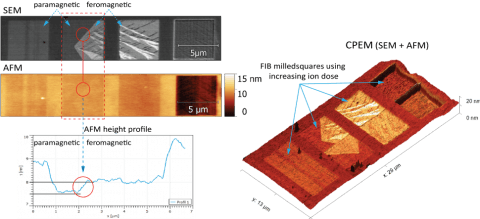
Modificación superficial de telururo de cadmio
El telururo de cadmio (CdTe) es un semiconductor con una amplia gama de aplicaciones que van desde detectores de rayos X o gamma hasta células solares. Debido a la heterogeneidad del compuesto de CdTe, la planaridad de las estructuras grabadas con haz de iones enfocados (FIB) es desigual y requiere la optimización del proceso de fresado de FIB.
Beneficios de LiteScope:
- La modificación de la superficie mediante técnicas FIB/GIS se puede realizar directamente en un LiteScope inclinado dentro de SEM, lo cual es crucial para muestras sensibles propensas a la oxidación.
- Evaluación inmediata del perfil superficial modificado y control de calidad del proceso.
- Optimización del proceso de fresado FIB mediante tasa de pulverización catódica y estimación de rugosidad.
Publicado por cortesía de: Ondrej Sik y Martin Konecny, CEITEC BUT, República Checa, y Veronika Hegrová, NenoVision, República Checa.
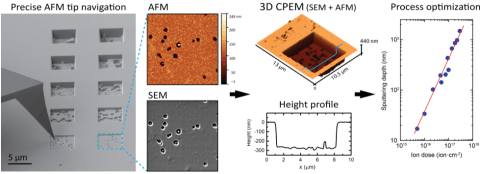
Mapeo de conductividad de silicio microcristalino
El silicio microcristalino es una película de silicio donde los tamaños de los cristales de silicio son del orden de decenas de nanómetros. Las películas delgadas μc-Si: H son adecuadas para varios dispositivos, como TFT, células solares delgadas con mayor absorción de IR y más estables contra la radiación solar. LiteScope admite el análisis AFM conductivo ( cAFM ) dentro de SEM, lo que ayuda a localizar fácilmente estructuras particulares y evaluar el mapeo de conductividad con precisión nanométrica.
Beneficios de LiteScope:
- AFM-in-SEM permite imágenes y análisis correlativos complejos
- SEM: contraste de materiales y localización rápida de nanoestructuras
- c-AFM: topografía y mapa de conductividad
Publicado por cortesía de: RNDr. Antonín Fejfar, Academia Checa de Ciencias, Chequia
Nanopatrones magnéticos de Fe78Ni22 usando un haz de iones enfocado
La película delgada de Fe78Ni22 metaestable que crece sobre un sustrato de cobre tiene el potencial de formar patrones magnéticos: es paramagnético a temperatura ambiente, pero puede transformarse mediante la irradiación FIB en un material ferromagnético. La medición simultánea de las señales AFM y SEM reveló que la transformación de la cristalografía va acompañada de un cambio de topografía.
Beneficios de LiteScope:
- La modificación de la superficie mediante técnicas FIB/GIS se puede realizar directamente en un LiteScope inclinado dentro de SEM, lo cual es crucial para muestras sensibles propensas a la oxidación.
- Evaluación inmediata del perfil superficial modificado y control de calidad del proceso.
Publicado por cortesía de: Lukas Flajsman, CEITEC BUT, Chequia
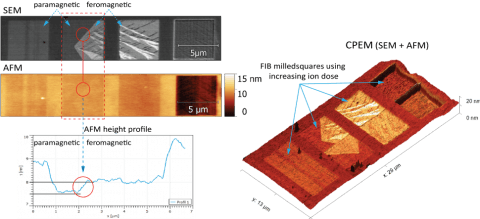
Decapado de circuito integrado
Debido a la miniaturización, el análisis de fallas de los circuitos integrados avanzados solo es posible mediante la eliminación de capas de haz de iones enfocados localmente (FIB). Es necesario analizar la planaridad y la rugosidad de las superficies decapadas.
Beneficios de LiteScope:
- Identificación precisa de una capa en particular, planaridad excelente de estructuras fresadas FIB con daño mínimo a la muestra.
- Reconstrucción 3D: evaluación in situ de la topografía y rugosidad de la estructura fresada.

Imágenes de dislocaciones de roscado en películas de GaN/AlN/Si
El nitruro de galio (GaN) es un material muy prometedor para aplicaciones electrónicas y optoelectrónicas; sin embargo, puede ocurrir una variedad de dislocaciones en la interfaz de diferentes materiales, lo que conduce a películas de baja calidad.
Beneficios de LiteScope:
- Varios defectos se pueden localizar y caracterizar solo mediante la vista CPEM, que combina AFM, SEM y EBIC (corriente inducida por haz de electrones).
- CPEM permite una comparación directa entre la topografía de la superficie, la actividad eléctrica y la química de la superficie de la muestra.
Publicado por cortesía de: Roman Gröger, IPM CAS, República Checa
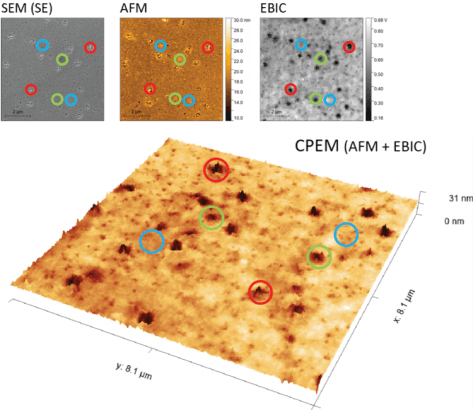
Imágenes correlativas que combinan AFM-in-SEM y ToF-SIMS de metal con partículas de Li y Al
La espectrometría de masas de iones secundarios de tiempo de vuelo (ToF-SIMS) proporciona información elemental, del estado químico y molecular de las superficies de los materiales sólidos. La aleación con partículas de litio y aluminio se utiliza para la verificación de la sensibilidad de los detectores SIMS para elementos ligeros.
La correlación de SEM ToF-SIMS con AFM proporciona la topografía de muestra faltante y permite el cálculo de, por ejemplo, tasas de pulverización catódica para optimizar el proceso, lo cual es crucial especialmente para materiales heterogéneos.
Beneficios de LiteScope:
- Localización rápida y precisa de estructuras superficiales.
- Evaluación inicial de la topografía de la muestra y visualización 3D CPEM del volumen pulverizado que contiene el contraste del material SEM.